| 研究活動 | ||
| −主要研究項目− | ||
| 1. 高誘電率ゲート絶縁膜(High-k膜)の材料科学 | ||
| 2. Ge-CMOSをめざした界面場制御 | ||
| 3. 2次元系半導体物性 | ||
| 4. 機能性酸化物 FET | ||
1.高誘電率ゲート絶縁膜(High-k膜)の材料科学 半導体素子の超微細化のためには,絶縁膜容量を増大(=絶縁膜の薄膜化)させつつリーク電流を増大させないゲート絶縁膜が要求されます。当研究室では,従来のSiO2を高誘電率絶縁膜(High-k膜)で代替することによって『SiO2換算で1nm以下相当』まで薄膜化されたゲート絶縁膜を実現することを目標として,新しい絶縁膜材料の開発を進めています。
HfO2の多元化による高性能化
有望なHigh-k材料であるHfO2にYやSiを添加することで誘電率を大幅に向上させることに成功しました。多元化とその組成制御がHigh-k材料の相を制御するキーであると考え,高誘電率化,結晶化温度の向上へ向けた材料設計を試みています。 |
||
 
|
||
|
マルチターゲットスパッタ
|
分子線エピタキシ (MBE)
|
|
パルスレーザー堆積法(PLD) |
レーザーアブレーションの瞬間 | |
| 構造制御に依る誘電率の向上 | ||
 |
||
SSDM 2004 (K. Kita et al.) で、我々はHfO2の結晶相を制御することにより、その比誘電率を約30まで向上することに世界で初めて成功した。特に結晶相を制御するための手法として、Y等の異なる元素をHfO2にドープすることが有効であることを示した[K. Kita et al., APL 2005.]。さらに この技術を応用することで、SiドープHfO2[K. Tomida et al., APL 2006]、 LaYOx [Y. Zhao et al., APL 2009]、LaTaOx [Y. Zhao et al., JAP 2009]等の新しい3元 high-k膜を開発している。 |
||
| 高速熱処理に依るhigh-k膜の構造制御 | ||
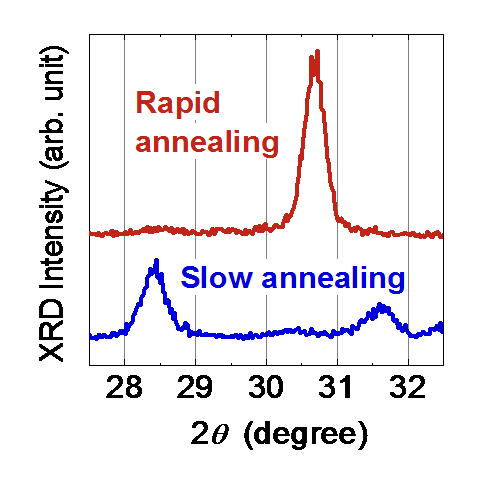 |
||
高速熱処理 |
||
我々はさらに、異なる元素をドープするのではなく、高速熱処理を駆使することによって、HfO2の構造を制御する研究を開始した。HfO2が結晶する際にまず高対称相の構造を経て低対称相の構造に安定化するという点に着目すれば[Y. Nakajima et al., ECS Trans. 2010]、高速加熱・冷却で的確な熱処理を施すことでHfO2の構造を最適化し、その誘電率を広い範囲で変調することができる。 |
||
| 酸化物界面のダイポール形成 | ||
high-k/金属ゲートの制御技術の中でも、FETの閾値電圧を制御する技術は特に重要である。なぜならhigh-k/金属ゲートのフラットバンド電圧は用いるhigh-k材料に依って大きく変化してしまうからである。 2006年に我々は、FETの閾値電圧を制御するためにはhigh-k/SiO2界面のダイポールを制御することが要であることを明らかにした[Y. Yamamoto et al., JJAP 2007]. |
||
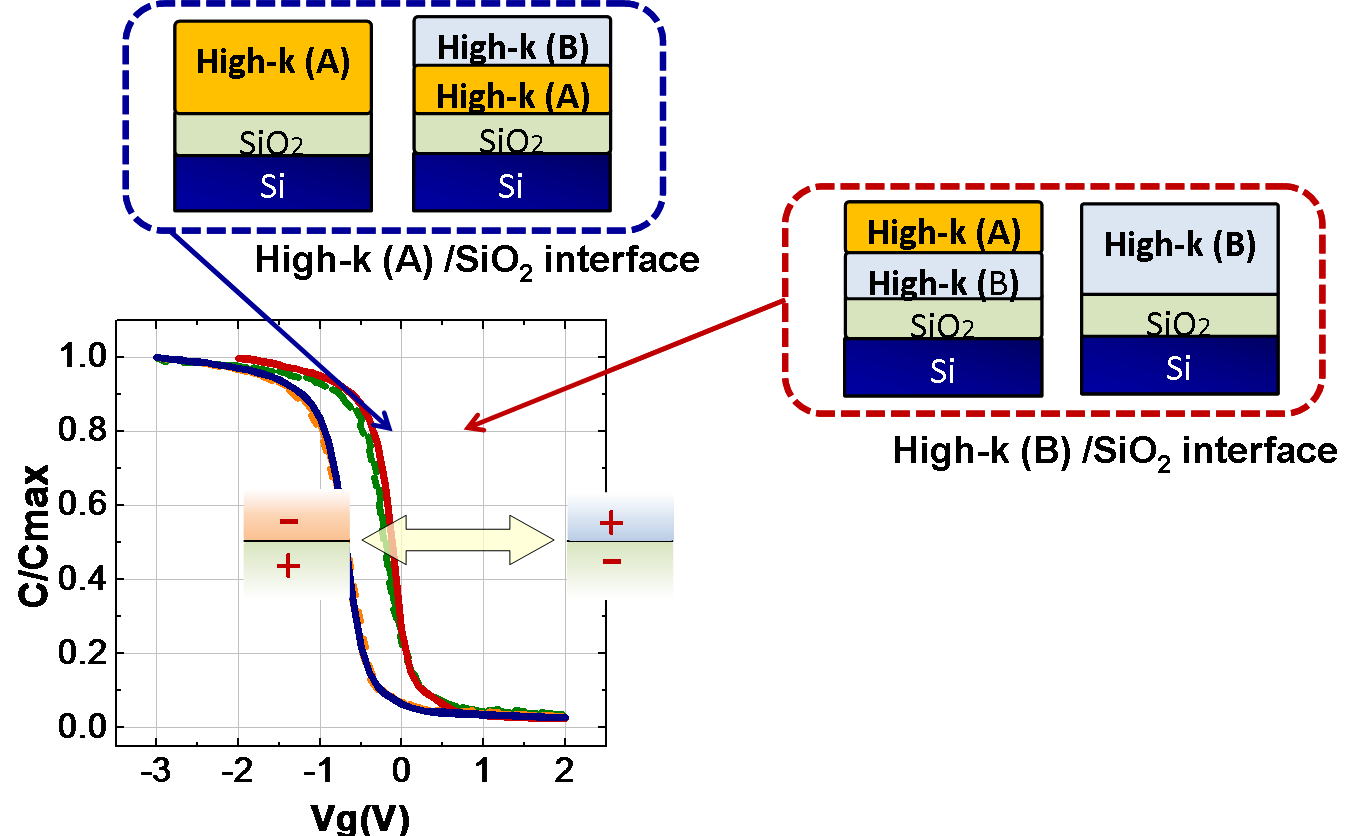 |
||
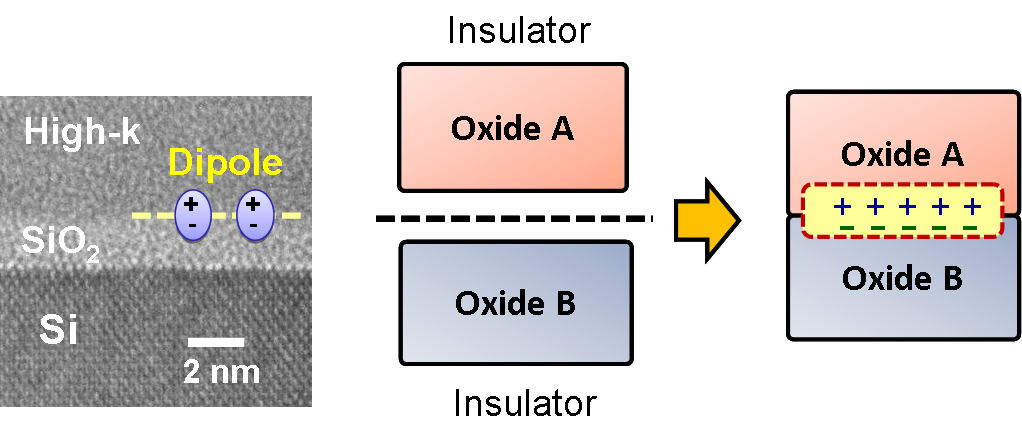 |
||
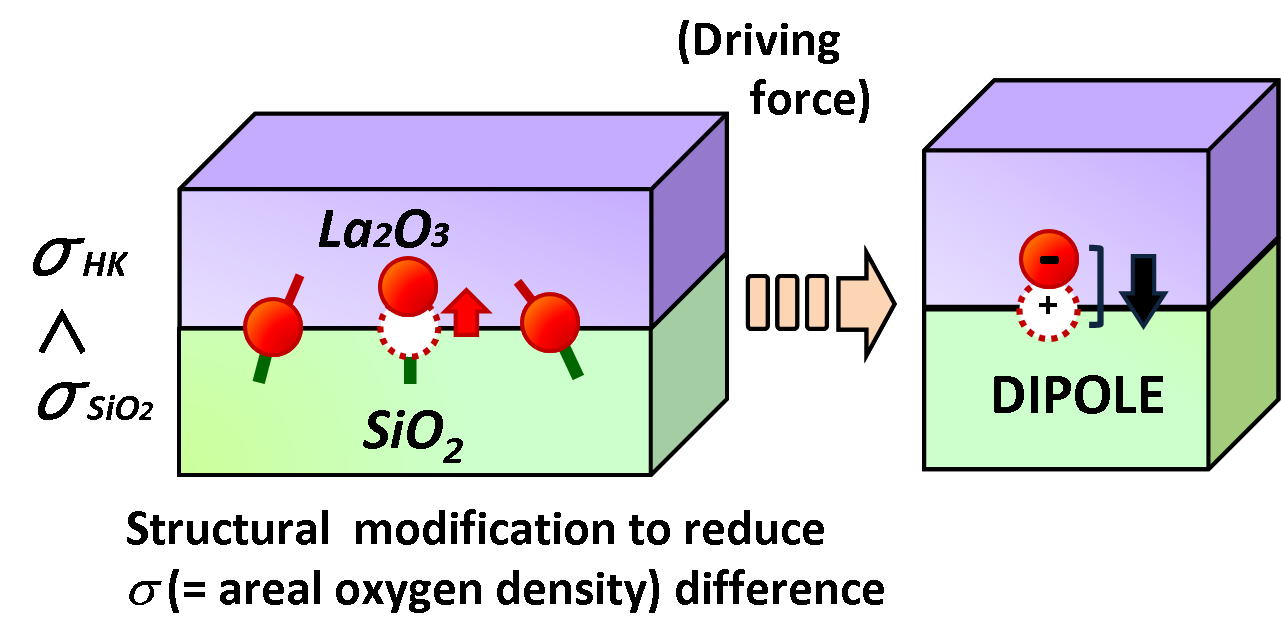 |
||
2008年にはさらに、high-k/SiO2界面のダイポール生成機構を提案した[K. Kita and A. Toriumi, IEDM 2008, San Francisco]。そこでは、界面を形成する2種類の酸化物の構造の違い(特に酸素原子の面密度の違い)が、ダイポールの方向と大きさを決定することを示した[K. Kita and A. Toriumi, APL 2009]。 |
||
| ページトップ
2 Ge-CMOSをめざした界面場制御 |
||
Geは,Siよりも優れた電子物性を持つ半導体ですが, Ge酸化物が化学的・熱力学的に不安定性であるためにデバイス材料としては注目されてきませんでした。 当研究室では,High-k膜(高誘電率ゲート絶縁膜)とGeの組合せであれば高性能微細FETが可能になると考え、 その実現のために必要な基礎技術の確立と,実デバイスの作製を試みています。 これまでにHfO2/Ge MISキャパシタを形成し,Ge基板上に界面反応層をつくることなく成膜できること、 また良好な電気特性が得られることを実証しています。 しかしその一方でGeに高温での熱処理を適用するのは困難であり、 特に、酸素を含む雰囲気中ではGe表面での激しい反応が確認されています。 このようにSiとは大きく異なるGe特有の現象を把握した上で適切なプロセス条件を模索しています。。 |
||
| GeO2/Ge界面のGeO脱離 | ||
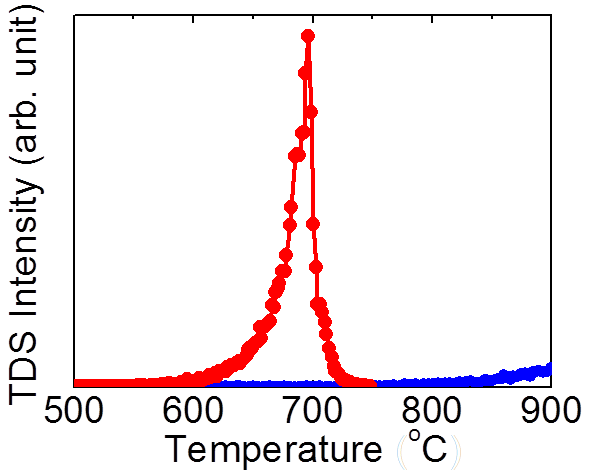

|
||
| GeOの昇温脱離分析 | 700oC酸素中のGe (111) 表面 | |
熱的に不安定なGeO2が脱離すると、Ge MOSFETの電気特性が悪化します。 我々はまずGeO脱離の基板依存性を調べました。左の図はGeOの昇温脱離分析の結果です[K. Kita et al., JJAP 2008]。 低温でのGeO脱離はGeO2/Ge界面でGe + GeO2 -> 2GeO反応が進行することによって起きることを明らかにしました。 |
||
| GeO脱離のメカニズム(何が拡散しているのか?) | ||

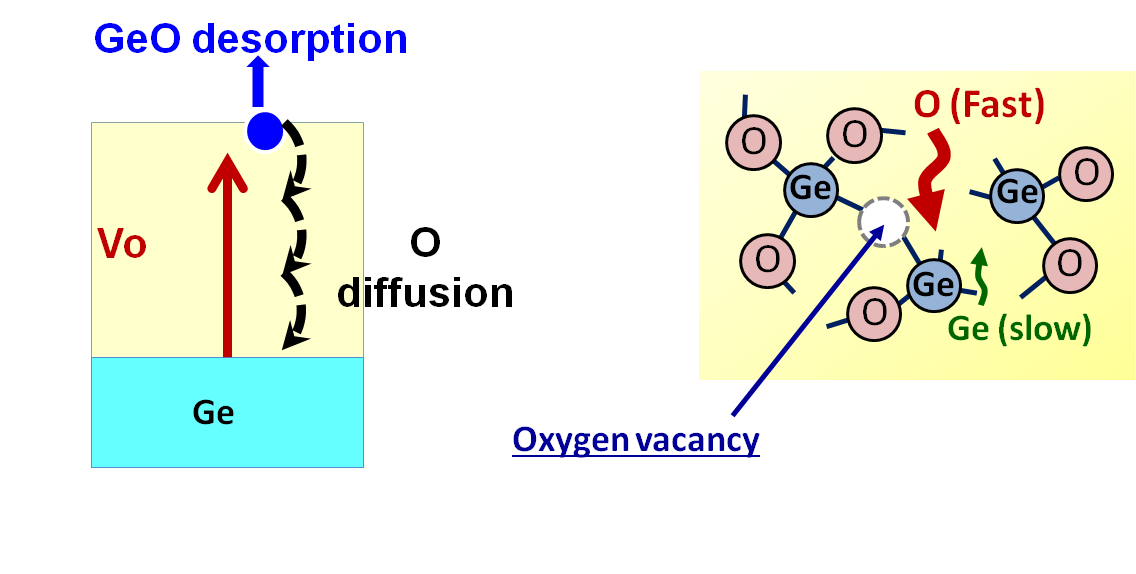 |
||
GeO脱離はGeO2中の拡散によってリッソクされています[S. K. Wang et al., JAP 2010]。 ここで酸素同位体を用いて、何が拡散しているのかつきとめました。 左の図は、通常の16Oとその同位体18Oの昇温脱離分析の結果です。 初めに脱りするGeOの酸素はGeO2の表面側に元々いた通常の16Oであり、拡散しているのはGeOそのものではなく酸素欠損であることが分かりました[K. Kita et al., IEDM 2009]。 |
||
| GeO脱離に依るGeO2のバルク特性の劣化 | ||
 |
||
様々な処理を施したGeO2の、エリプソメトリ分光における消衰係数。 優れた電気特性を示すGeO2/Ge界面を作製するためには、熱力学的にも動力学的にもGeOの脱離を押さえるような高圧酸化が望ましいことを明らかにしました[C. H. Lee et al., APEX 2009]。 さらに高圧酸化はGeO2膜のバルク特性も改善し、GeO脱離に依って生じると思われるギャップ内吸収(<6 eV)が少なくなることも分かりました[K. Kita et a l., IEDM 2009].。 |
||
| 高圧酸化されたGeO2/Ge界面 | ||
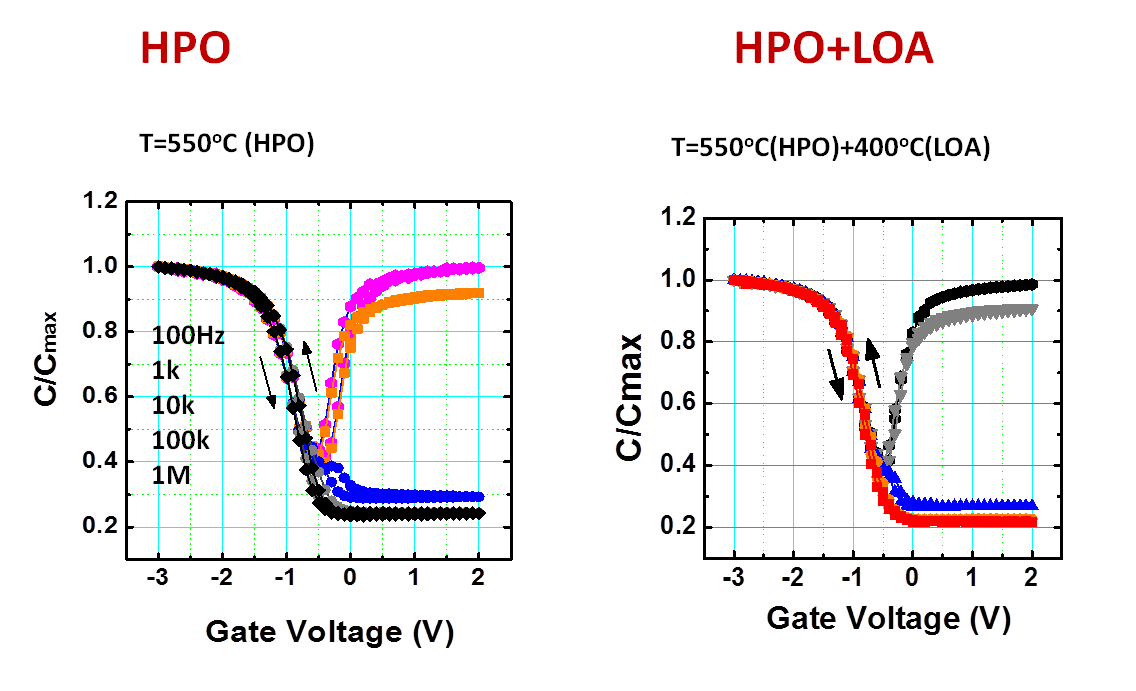 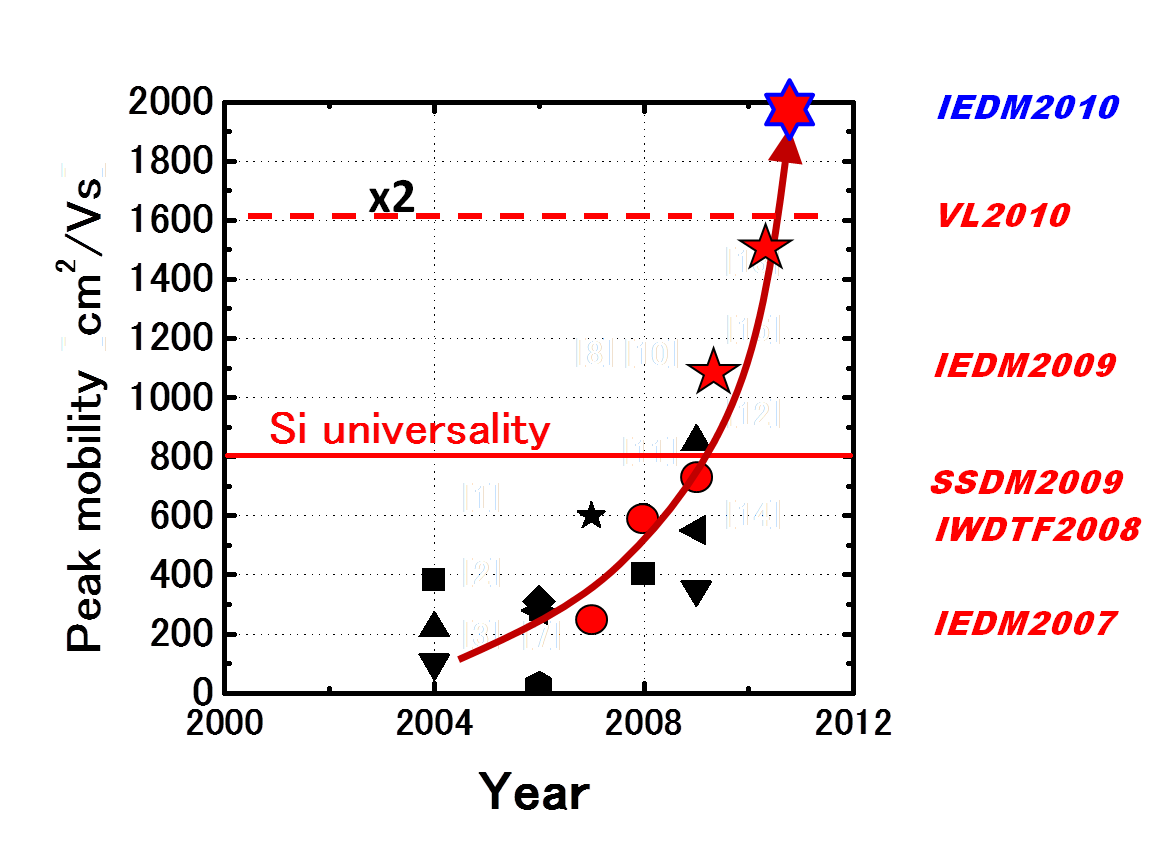 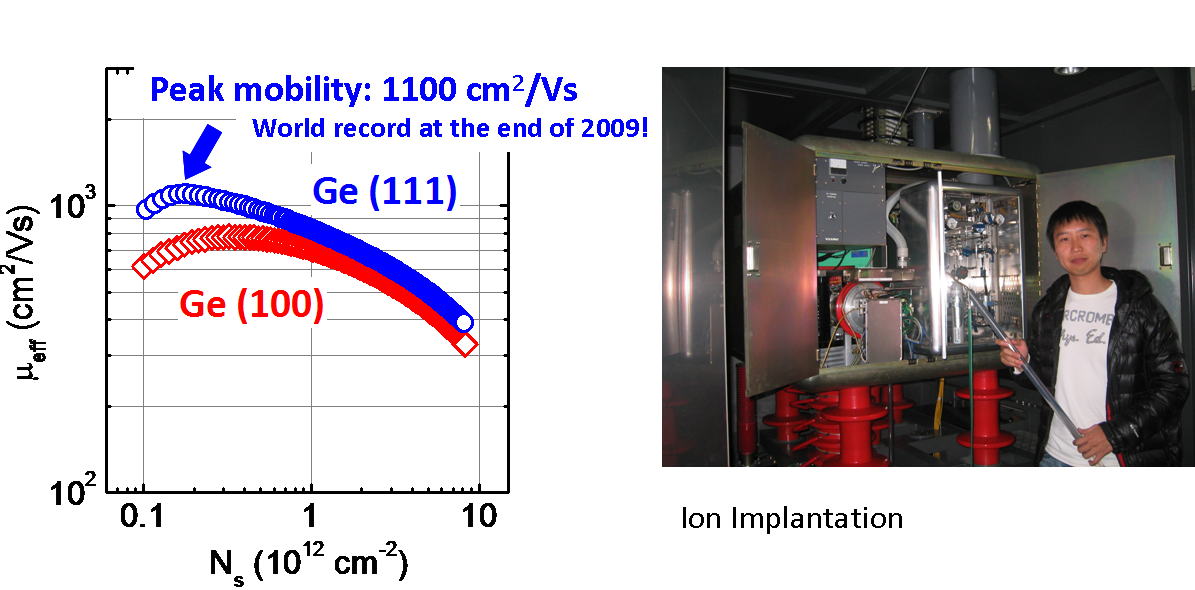 高圧酸化GeO2[C. H. Lee APEX 2009]とGe (100) または (111)から作製したnMOSFETは、 小さな電子有効質量*と優れた安定性を持つことが分かりました[M. Toyama et al., SSDM 2004]。 Ge (111)でのピーク移動度は300Kで1100cm2/Vsに達し、Siのユニバーサルカーブに比べて1.5倍の改善が見られました。 *S. Takagi, 2003 Symposium on VLSI Technology Digest of Technical Papers |
||
| Geとの親和性が高いhigh-k材料の探索 | ||
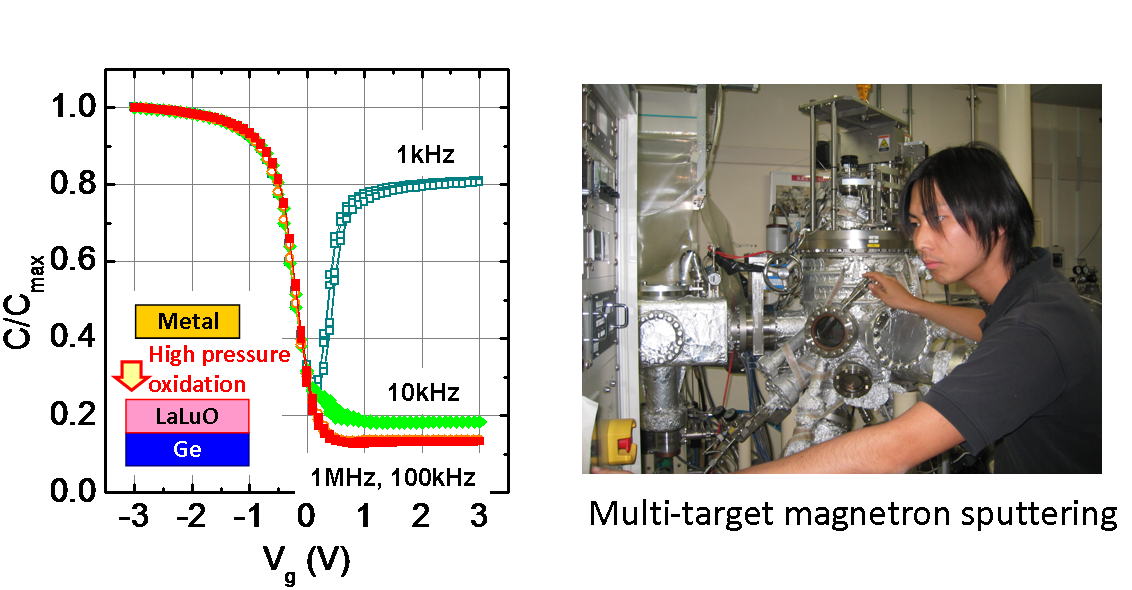 |
||
高圧酸化処理したLaLuO(希土類酸化物)/Ge MISキャパシタのC-V特性。 微細化に依ってGe MOSFET特性を向上させるには、Si MOSFET同様、high-k材料が必要になります。 我々はGeに対して希土類酸化物からなるhigh-k膜を用いることで、優れた電気特性が得られることを明らかにしてきました[K. Kita et al., Appl. Surf. Sci. 2008]。 さらにこのようにGeへの親和性が高い希土類酸化物に高圧酸化処理を施すことで、理想的なC-V特性が得られることを示しました[T. Tabata et al., ECS Trans. 2008]。 現在は、希土類元素がどのような界面パッシベーション効果を有しているのかを、原子レベルで解明しようとしています。 |
||
| 金属/Ge界面での強いフェルミ準位ピニング | ||
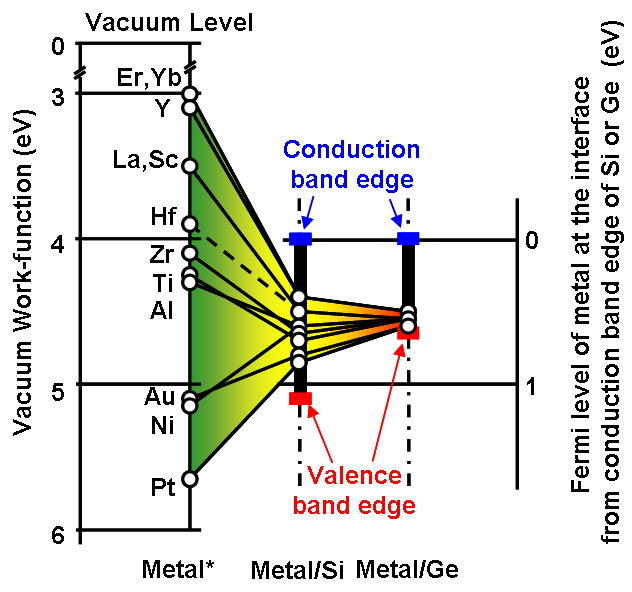 |
||
金属/Ge界面のバンドアラインメントは、金属の仕事関数に影響されません。 これは金属のフェルミ準位がGeの価電子帯上限に強くピニングされているからです。 結果、n型Geに対しては常にショットキー接合が形成され、p型Geに対しては常にオーミック接合が形成されます[T. Nishimura et al., APL 2007]。 現在、この強いピニングの原因を解明しようとしています。 |
||
| トンネルコンタクト | ||
 金属/Ge界面に極薄の絶縁膜を挿入することで、ショットキーからオーミックまで電気特性を完全に反転させることができます[T. Nishimura et al., APEX 2008]。 これはピニングの起源を明らかにする上で、重要なヒントになります。 |
||
| ページトップ
3 2次元系半導体物性 | ||
グラフェンの研究は 長汐研究室 を参照してください。 2004年4月から我々は、遷移金属カルコゲナイトの研究を立ち上げました。MoS2が極めて興味深い特性を示すことが分かってきました。 |
||
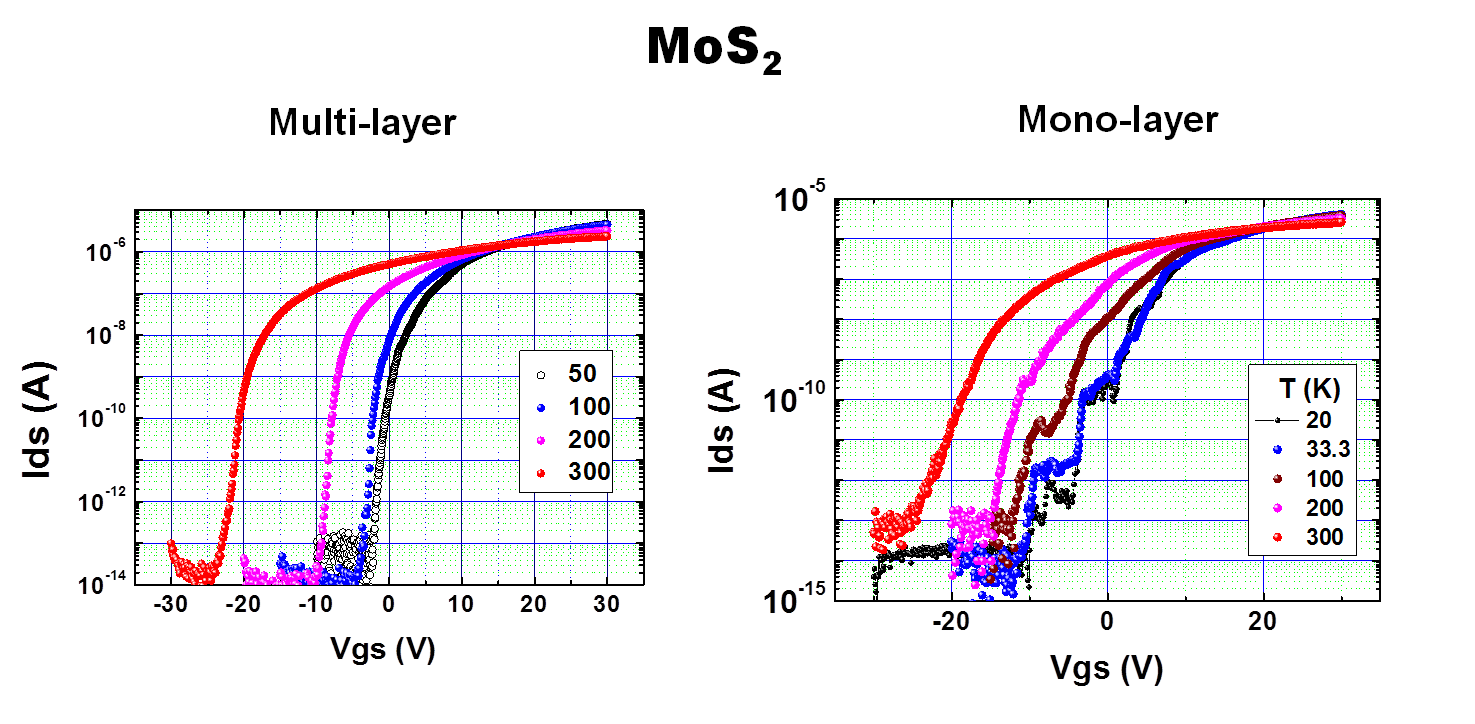 |
||
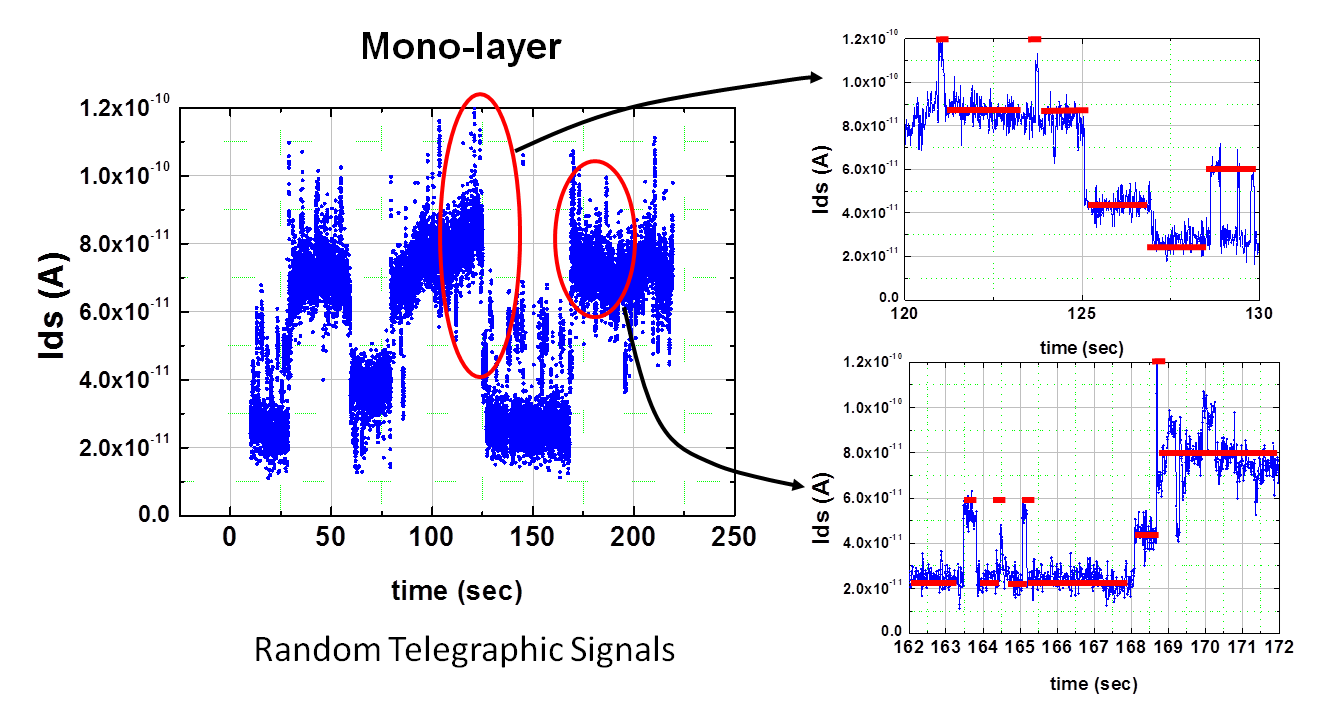 |
||
| ページトップ 4 機能性酸化物 FET 遷移金属酸化物の不可思議な性質を、電界効果トランジスタ(FET)という共通のプラットフォーム上で自在に制御し、 新しいエレクトロニクスの開拓を目指します。 |
||
| 電子の"集団"を電場で操り 超熱安定なトランジスタを実現する 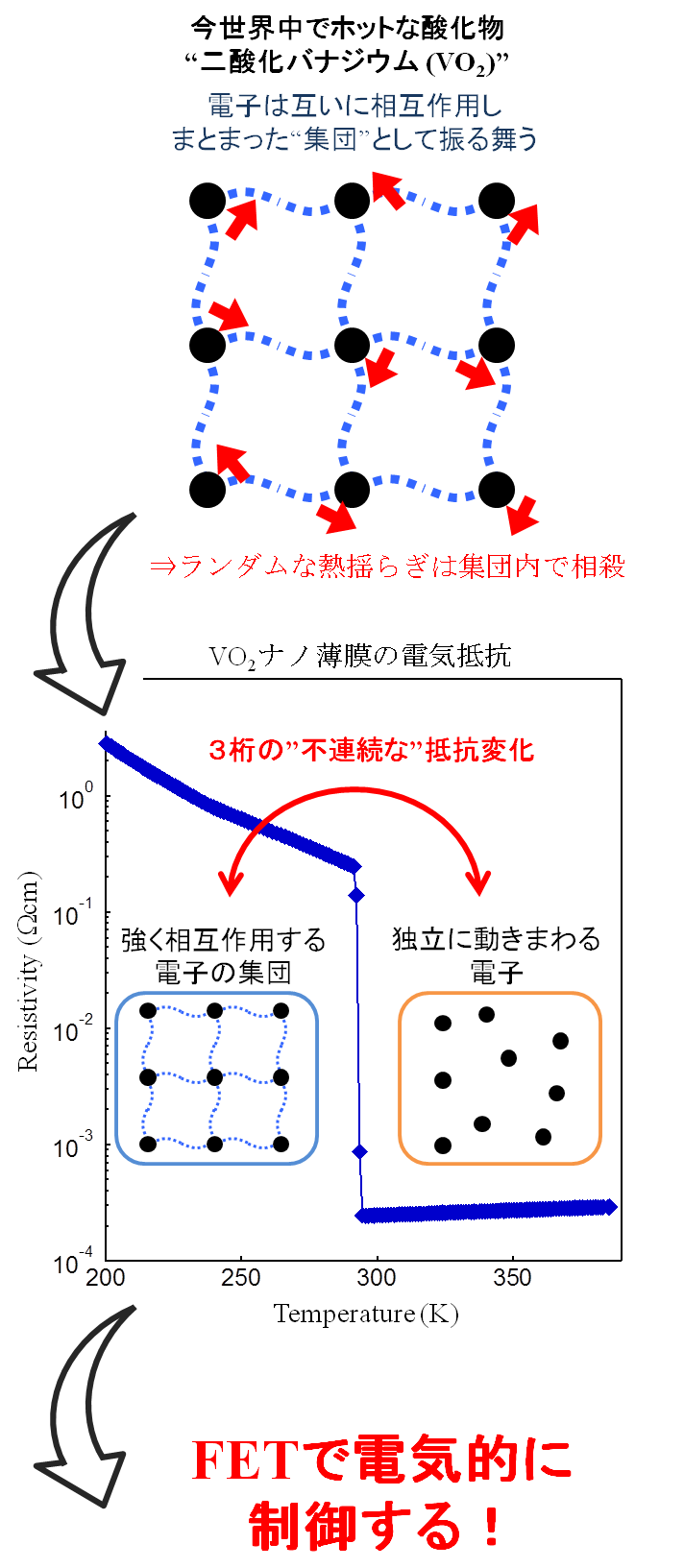
|
酸化物表面の微小水滴を 後ろから電気で動かす 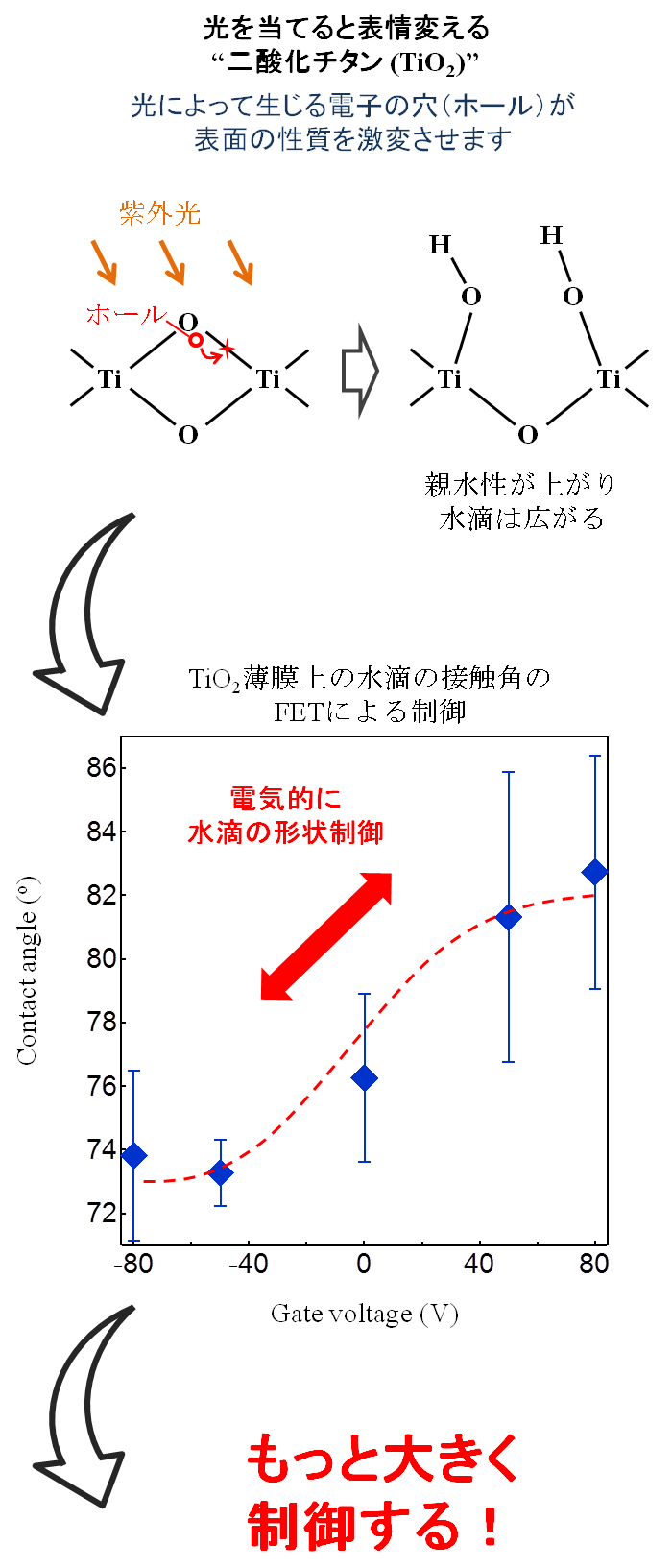
|
|
| ページトップ | ||
(at → @)